中国半导体两起重磅收购!拟实控韩国芯片上市公司
7月14日晚间,希荻微公告,公司二级全资子公司HMI拟以210.05亿韩元(折合人民币约1.09亿元),收购韩国创业板科斯达克上市公司Zinitix Co., Ltd.(简称“Zinitix”)合计30.91%的股权,交易完成后,HMI将持有Zinitix公司30.93%的股权,成为Zinitix第一大股东并能够主导其董事会席位,并将委派财务负责人等高级管理人员,对其经营、人事、财务等事项拥有决策权,Zinitix将成为公司控股子公司。公司与Zinitix同属集成电路设计企业,公司可通过此次交易快速扩大产品品类,尤其是触控芯片产品线,从而拓宽在手机和可穿戴设备等领域的技术与产品布局。
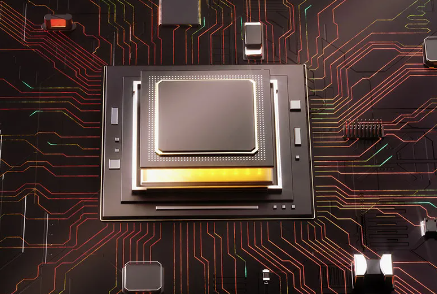
公告还称,Zinitix 的摄像头自动对焦芯片产品线与公司现有的音圈马达驱动芯片产品线有较强的协同性,有助公司进一步增大该产品线的市场份额及技术实力。另外,Zinitix 与公司现有客户亦有较高程度的重合,在业务上具有协同性。
公告显示,集成电路设计企业Zinitix于2000年成立,于2019年在韩国创业板科斯达克上市, 经过多年深耕及创新,已形成了多元化的产品品类和应用领域,主要产品包括触摸控制器(TouchController)芯片、自动对焦芯片、触控驱动(HapticDriver)芯片、DC/DC 电源管理芯片、触摸板模块以及音频放大器等,应用于智能手机、智能手表、平板电脑等移动/可穿戴设备等终端设备。
Zinitix的主要产品已进入国际知名终端品牌三星电子的供应链体系,成为其智能手机等消费电子产品的供应商之一。此外,Zinitix与包括全球智能设备制造商在内的50多个客户建立了业务关系。
希荻微成立于2012年,2022年1月21日于科创板挂牌上市,是国内领先的电源管理及信号链芯片供应商之一,主营业务为包括电源管理芯片及信号链芯片在内的模拟集成电路产品的研发、设计和销售。7月10日,希荻微发布了 2024年第一季度报告(更新版)。报告显示,公司在报告期内实现营业收入1.23亿元,同比增长205.94%。
另外,在7月14日晚间,国内的沈阳富创精密设备股份有限公司(以下简称“富创精密”)发布公告。
公告称,公司拟以现金方式收购公司实际控制人郑广文、公司第一大股东沈阳先进制造技术产业有限公司、北京亦芯企业管理咨询合伙企业(有限合伙)、辽宁中德产业股权投资基金合伙企业(有限合伙)、阮琰峰、天津芯盛企业管理咨询合伙企业(有限合伙)、中泰富力科技发展有限公司和辽宁和生中富股权投资基金合伙企业(有限合伙)8 名交易对方持有的北京亦盛精密半导体有限公司(以下简称“亦盛精密”)100%股权。
据悉,亦盛精密聚焦国内主流12英寸晶圆厂客户,可提供以硅、碳化硅、石英为基材的非金属零部件耗材、铝等金属材料为基材的金属零部件耗材和晶圆厂核心部件的维修、循环清洗和涂层再生服务,部分产品已通过国内主流12英寸 晶圆厂客户先进制程工艺认证,并实现量产出货。
此外,亦盛精密80%以上的收入来自于国内主流的12英寸晶圆厂中逻辑和存储代工类型客户,也有部分外资12英寸晶圆厂客户和贸易商客户,亦盛精密90%以上的收入来自于非金属和金属半导体零部件产品。
公告称,本次交易正在进行审计评估,交易金额尚未确定,预计不超过8亿元。公司未与本次交易对方签订与本次交易相关的任何意 向性协议。
本次交易完成后,亦盛精密将成为富创精密全资子公司。
在线留言询价

半导体的基础定义及常见类型有哪些?

高性能芯片的基石:半导体封装技术全解析!

2025年全球半导体TOP10!
- 一周热料
- 紧缺物料秒杀
| 型号 | 品牌 | 询价 |
|---|---|---|
| RB751G-40T2R | ROHM Semiconductor | |
| CDZVT2R20B | ROHM Semiconductor | |
| MC33074DR2G | onsemi | |
| BD71847AMWV-E2 | ROHM Semiconductor | |
| TL431ACLPR | Texas Instruments |
| 型号 | 品牌 | 抢购 |
|---|---|---|
| BU33JA2MNVX-CTL | ROHM Semiconductor | |
| ESR03EZPJ151 | ROHM Semiconductor | |
| STM32F429IGT6 | STMicroelectronics | |
| BP3621 | ROHM Semiconductor | |
| TPS63050YFFR | Texas Instruments | |
| IPZ40N04S5L4R8ATMA1 | Infineon Technologies |
AMEYA360公众号二维码
识别二维码,即可关注


请输入下方图片中的验证码:























