
行业新闻
英特尔将获美国35亿美元芯片补贴
关键词:
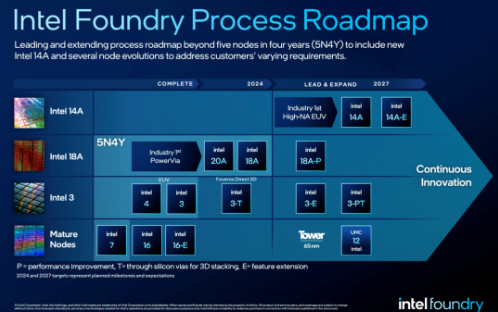
行业新闻
英特尔晶圆代工,更新路线图
关键词:
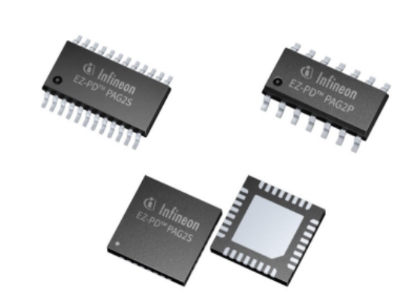
行业新闻
英特尔实现3D先进封装技术实现大规模量产
关键词:
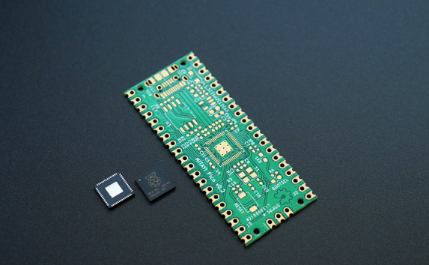
行业新闻
英特尔与台积电联手开发多晶片封装芯片
关键词:
- 一周热料
- 紧缺物料秒杀
| 型号 | 品牌 | 询价 |
|---|---|---|
| RB751G-40T2R | ROHM Semiconductor | |
| TL431ACLPR | Texas Instruments | |
| CDZVT2R20B | ROHM Semiconductor | |
| MC33074DR2G | onsemi | |
| BD71847AMWV-E2 | ROHM Semiconductor |
| 型号 | 品牌 | 抢购 |
|---|---|---|
| TPS63050YFFR | Texas Instruments | |
| BP3621 | ROHM Semiconductor | |
| ESR03EZPJ151 | ROHM Semiconductor | |
| IPZ40N04S5L4R8ATMA1 | Infineon Technologies | |
| BU33JA2MNVX-CTL | ROHM Semiconductor | |
| STM32F429IGT6 | STMicroelectronics |
热门标签
ROHM
Aavid
Averlogic
开发板
SUSUMU
NXP
PCB
传感器
半导体
资讯排行榜
关于我们
AMEYA360公众号二维码
识别二维码,即可关注


AMEYA360商城(www.ameya360.com)上线于2011年,现有超过3500家优质供应商,收录600万种产品型号数据,100多万种元器件库存可供选购,产品覆盖MCU+存储器+电源芯 片+IGBT+MOS管+运放+射频蓝牙+传感器+电阻电容电感+连接器等多个领域,平台主营业务涵盖电子元器件现货销售、BOM配单及提供产品配套资料等,为广大客户提供一站式购销服务。




























