三星独霸OLED怎么破,群创准备走Micro LED这条路?
发布时间:2017-07-03 00:00
作者:
来源:经济日报
阅读量:1298
鉴于南韩三星独霸全球OLED面板的地位难以撼动,面板大厂群创另辟蹊径,押宝微发光二极管(Micro LED),并且率先布局2018年即可量产的次毫米发光二极管 (Mini LED)技术,要抢进商机庞大的车用面板市场。
鸿海集团顾问段行建已证实,夏普与群创将在OLED面板有更多合作,将整合彼此资源、不重复投资。 他说,群创已派出OLED人才赴日,协助夏普新4.5代OLED厂量产。
业界认为,面板双虎友达及群创,迄今无法切入智能型手机OLED面板市场。 未来群创可望透过携手夏普,与三星竞逐下世代苹果iPhone高阶面板订单。
群创技术开发中心负责人丁景隆表示,确信Micro LED将是下一代显示器技术主流,然而尚待解决数百万颗以上Micro LED巨量移转的问题。 因此,群创已投入次毫米发光二极管Mini LED技术开发,获得各车厂的关注。 Mini LED搭配软性基板的应用,被视为取代OLED成为车用面板的最佳选择。
(备注:文章来源于网络,信息仅供参考,不代表本网站观点,如有侵权请联系删除!)
在线留言询价
相关阅读

行业新闻
三星独家供货英伟达12层HBM3E内存
2024-03-25 16:30
阅读量:541

行业新闻
三星SDI工厂突发火灾!
2024-03-22 13:19
阅读量:446
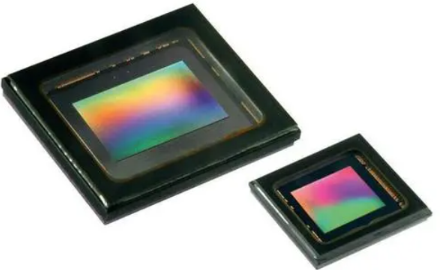
行业新闻
消息称三星将扩大采用索尼相机传感器
2024-03-14 11:19
阅读量:1151
- 一周热料
- 紧缺物料秒杀
| 型号 | 品牌 | 询价 |
|---|---|---|
| MC33074DR2G | onsemi | |
| TL431ACLPR | Texas Instruments | |
| BD71847AMWV-E2 | ROHM Semiconductor | |
| RB751G-40T2R | ROHM Semiconductor | |
| CDZVT2R20B | ROHM Semiconductor |
| 型号 | 品牌 | 抢购 |
|---|---|---|
| ESR03EZPJ151 | ROHM Semiconductor | |
| IPZ40N04S5L4R8ATMA1 | Infineon Technologies | |
| STM32F429IGT6 | STMicroelectronics | |
| TPS63050YFFR | Texas Instruments | |
| BU33JA2MNVX-CTL | ROHM Semiconductor | |
| BP3621 | ROHM Semiconductor |
热门标签
ROHM
Aavid
Averlogic
开发板
SUSUMU
NXP
PCB
传感器
半导体
资讯排行榜
相关百科
关于我们
AMEYA360公众号二维码
识别二维码,即可关注


AMEYA360商城(www.ameya360.com)上线于2011年,现
有超过3500家优质供应商,收录600万种产品型号数据,100
多万种元器件库存可供选购,产品覆盖MCU+存储器+电源芯
片+IGBT+MOS管+运放+射频蓝牙+传感器+电阻电容电感+
连接器等多个领域,平台主营业务涵盖电子元器件现货销售、
BOM配单及提供产品配套资料等,为广大客户提供一站式购
销服务。